免费预约实验:18733501586
免费定制方案:18733501586
库存充足 | 极速发货 | 终身维护
欢迎来到 河北兰蒂斯环保科技有限公司官网!公司主要产品臭氧发生器,臭氧消毒机,臭氧机等
二十多年来,半导体行业研究人员已经研究了将臭氧用于晶片清洁和抗蚀剂剥离应用的情况。为了降低化学药品的消耗和处置成本以及提高清洁效率,使用臭氧以替代传统的使用碱性(SC-1)和酸性(SC-2)氢的硫酸-过氧化物和RCA清洁过氧化物混合物。
在芯片制造过程中,臭氧主要用于清洁晶圆;消除有机物,金属和颗粒;去除光刻胶;对去离子水设施进行消毒。用臭氧清洁总是涉及氧化,工艺差异取决于清洁步骤的主要目的。
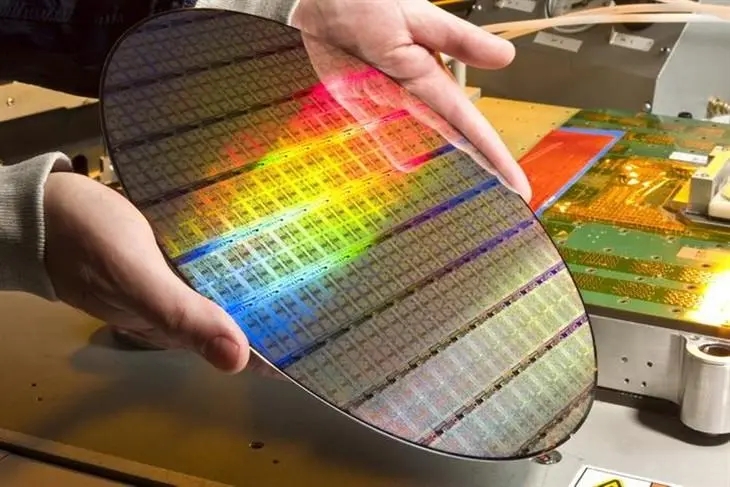
1.去除有机物
关于臭氧去除有机物的能力,可以从臭氧用在饮用水和废水的处理研究中获得。臭氧处理过的去离子水(DIO3)具有很高的氧化潜能,可以降低有机污染物的含量。它的去除效率取决于有机物种类,臭氧浓度和反应方式。
溶于超纯水中的臭氧在自分解过程中会产生OH活性自由基。臭氧直接分解有机物时,活性自由基则间接分解有机物。不同的反应途径导致不同的氧化产物。直接的臭氧反应途径是选择性的,反应速率常数通常较慢。间接OH反应快速且非选择性,但必须通过引发剂(例如高pH,过氧化氢或UV辐射)激活。尽管期望快速反应,但是应避免仅由自由基进行的反应。在许多情况下,活性物种必须直接作用于表面,因为离表面太远生成的物种会失活和丢失。
2.去除金属和颗粒
单独的DIO3不能有效去除沉积在硅表面的铁,镍,铝,镁和钙等金属,例如金属氢氧化物或金属氧化物。取决于它们的性质,金属可以结合到氧化物层中或驻留在Si-SiO 2 界面处。可以用充当离子交换剂的酸除去它们,或者可以使用氢氟酸(HF)溶解氧化物,从而除去金属。
如果DIO3 具有有机性质,则仅DIO3可能足以去除其附着的颗粒。然而,通常通过用稀氢氟酸(dHF)蚀刻颗粒下方的氧化物并避免颗粒再沉积来去除二氧化硅上的颗粒。如果粒子的大部分未被dHF溶解,则O3作为氧化剂可产生可被HF蚀刻的新层。对于硅颗粒和硅表面而言确实如此。
在硅上形成氧化物层是自限过程。在室温下,硅表面的氧化会形成一个氧化层,其厚度可达到约1 nm。薄氧化物层的质量取决于其他参数,例如湿度。在涉及喷雾和浸没工具的测试中,初始氧化物生长速率是臭氧浓度的函数。在浸没工具中,最终氧化物厚度取决于初始臭氧浓度和pH值,表明反应受限。但是,由于在这些测试中使用了静态系统,因此臭氧的衰减和消耗可能会影响结果。
关于将臭氧与HF和/或盐酸(HCl)或两者结合的清洁工艺的一些研究已经发表。在这些研究中,将化学药品依次或以混合物的形式应用在喷雾,浸浴或单晶片工艺中。
重复使用臭氧水和稀氟化氢(SCROD)方法进行单晶片旋转清洗,将稀的dHF和DIO3交替分配在旋转的晶片上。9根据所需的表面最终条件,该过程以dHF /漂洗或DIO3 /漂洗结束,然后在氮气中旋转干燥。一分钟的三周期过程可以除去87%的Al 2 O3颗粒,97%的Si 3 N 4颗粒和99.5%的聚苯乙烯胶乳颗粒。与采用dHF和DIO3的方法相反 同时,重复的SCROD清洁不会增加表面粗糙度。
3.光刻胶去除
用于去除光刻胶的传统湿化学工艺依赖于浓硫酸与过氧化氢(SPM)或臭氧(SOM)的结合。使用溶解在去离子水中的臭氧的另一种方法可带来环境效益并降低成本。
DIO3中的光致抗蚀剂剥离速率随臭氧浓度或温度(在恒定臭氧浓度下)的增加而增加。不幸的是,随着温度的升高,水中的饱和臭氧浓度会降低,而臭氧衰减率会增加。必须仔细优化臭氧的输送过程,以达到最大的光刻胶去除率。
一些文献报道了在抗蚀剂剥离工艺中使用臭氧的几种尝试。例如,在使用时将臭氧与去离子水混合以达到较高的臭氧浓度,并且添加了清除剂以防止臭氧衰减。10-13 已发现剥离速率受溶解的臭氧从散装液体进入晶片表面边界层的传质速率的影响。可以通过采用超音速搅拌或通过减小边界层的厚度(例如,通过提高旋转工具中的晶片旋转速度)来减少扩散限制。为了克服边界层屏障的影响,研究人员在高温下将臭氧气体与水蒸气混合。12 清除剂的添加和温度的升高提高了剥离速度。然而,取决于抗蚀剂的类型和所使用的曝光后处理,使用湿法清洁工艺去除光致抗蚀剂仍然是一个挑战。
4.消毒
大约一个世纪前,将臭氧引入水处理系统的目的是对微生物污染的水进行消毒。在半导体世界中,臭氧用于消毒水净化系统。但是,用于净化饮用水的化学药品(如氯或二氧化氯)在IC工业中是不可接受的。臭氧的一个优点是它会分解回氧气。但是,在封闭的水净化系统中,氧气浓度会累积到高于《国际半导体技术路线图》中指定的水平。
水消毒所需的臭氧浓度远低于晶片清洁所需的臭氧浓度。一个关键参数是游离消毒剂浓度c乘以可用接触时间 t(CT值)。 CT值1.6-2.0 mg / L / min被认为足以有效消毒。
5.结论
随着晶圆结构的复杂性增加,晶圆湿法清洁工艺将继续在半导体制造中发挥重要作用。可靠的臭氧发生系统的发展使臭氧成为传统湿法清洁和光刻胶去除方法的有吸引力的替代方法。臭氧/水清洗工艺比RCA清洗技术便宜,而且对环境无害。臭氧不再仅仅对半导体应用具有科学意义;它可以在晶圆和IC制造过程中提供实际的好处。